SiC siliciokarbidoaparato rilatas al la aparato farita el siliciokarbido kiel la kruda materialo.
Laŭ la malsamaj rezistancaj proprecoj, ĝi estas dividita en konduktivajn siliciajn karbidajn potencajn aparatojn kajduon-izolita siliciokarbidoRF-aparatoj.
Ĉefaj aparatformoj kaj aplikoj de siliciokarbido
La ĉefaj avantaĝoj de SiC superSi-materialojestas:
SiC havas bendbreĉon 3-oblan tiun de Si, kio povas redukti elfluadon kaj pliigi la temperaturan toleremon.
SiC havas 10-oblan disfalan kampoforton ol Si, povas plibonigi la kurentdensecon, funkcian frekvencon, elteni tensian kapaciton kaj redukti la ŝaltitan-malŝaltitan perdon, pli taŭga por alttensiaj aplikoj.
SiC havas duoble la elektronsaturiĝan drivradrapidecon de Si, do ĝi povas funkcii je pli alta frekvenco.
SiC havas 3-oblan varmokonduktecon ol Si, pli bonan varmodisradian rendimenton, povas subteni altan potencan densecon kaj redukti varmodisradiajn postulojn, igante la aparaton pli malpeza.
Konduktiva substrato
Konduktiva substrato: Forigante diversajn malpuraĵojn en la kristalo, precipe malprofundajn malpuraĵojn, por atingi la internan altan rezistecon de la kristalo.
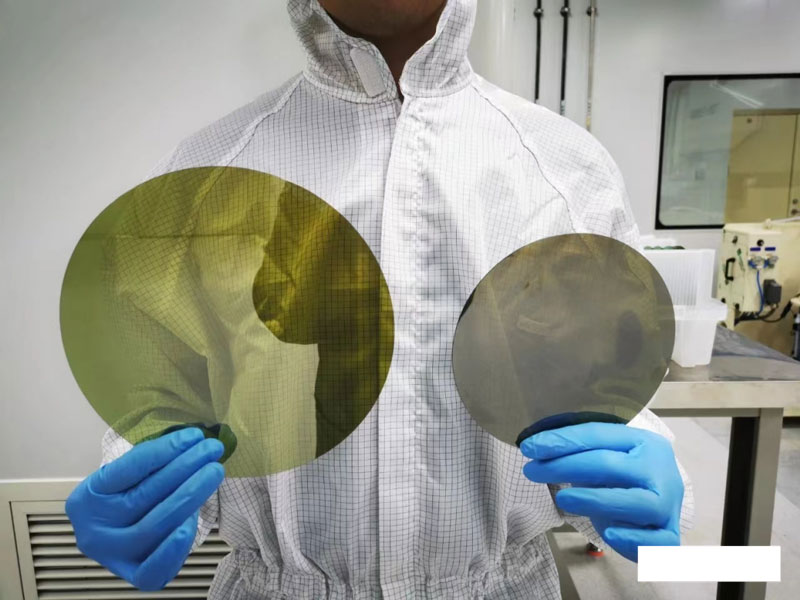
Konduktivasubstrato de siliciokarbidoSiC-oblateto
Konduktiva silicia karbida potenca aparato estas prilaborita per la kresko de silicia karbida epitaksa tavolo sur la konduktiva substrato, la silicia karbida epitaksa tavolo estas plue prilaborita, inkluzive de la produktado de Schottky-diodoj, MOSFET, IGBT, ktp., ĉefe uzataj en elektraj veturiloj, fotovoltaika elektroproduktado, fervoja transporto, datencentroj, ŝargado kaj alia infrastrukturo. La rendimentaj avantaĝoj estas jenaj:
Plibonigitaj altpremaj karakterizaĵoj. La disfala elektra kampa forto de siliciokarbido estas pli ol 10-obla ol tiu de silicio, kio faras la altpreman reziston de siliciokarbido-aparatoj signife pli alta ol tiu de ekvivalentaj siliciaj aparatoj.
Pli bonaj karakterizaĵoj por altaj temperaturoj. Silicia karbido havas pli altan varmokonduktivecon ol silicio, kio faciligas la varmodisradiadon de la aparato kaj pli altan liman funkcian temperaturon. Rezisto al altaj temperaturoj povas konduki al signifa pliiĝo de la potencdenseco, samtempe reduktante la postulojn pri la malvarmiga sistemo, tiel ke la terminalo povas esti pli malpeza kaj miniaturigita.
Malpli alta energikonsumo. ① Siliciokarbida aparato havas tre malaltan ŝaltreziston kaj malaltan ŝaltperdon; (2) La elflua kurento de siliciokarbidaj aparatoj estas signife reduktita ol tiu de silicioaparatoj, tiel reduktante potencperdon; ③ Ne ekzistas kurentmalkreska fenomeno en la malŝaltprocezo de siliciokarbidaj aparatoj, kaj la ŝaltperdo estas malalta, kio multe plibonigas la ŝaltfrekvencon de praktikaj aplikoj.
Duonizolita SiC-substrato: N-dopado estas uzata por precize kontroli la rezistecon de konduktivaj produktoj per kalibrado de la koresponda rilato inter nitrogena dopada koncentriĝo, kreskorapideco kaj kristala rezisteco.


Alta pureca duonizola substrata materialo
Duon-izolitaj siliciaj karbon-bazitaj RF-aparatoj estas plue fabrikataj per kreskigo de galium-nitrida epitaksa tavolo sur duon-izolita siliciokarbida substrato por prepari silician nitridan epitaksa tavolon, inkluzive de HEMT kaj aliaj galium-nitridaj RF-aparatoj, ĉefe uzataj en 5G-komunikadoj, veturilaj komunikadoj, defendaj aplikoj, datumtransdono, aerospaco.
La saturita elektrona drivorapideco de silicia karbido kaj galiumnitridaj materialoj estas 2,0 kaj 2,5 fojojn pli alta ol tiu de silicio respektive, do la funkcifrekvenco de silicia karbido kaj galiumnitridaj aparatoj estas pli granda ol tiu de tradiciaj siliciaj aparatoj. Tamen, galiumnitrida materialo havas la malavantaĝon de malbona varmorezisto, dum silicia karbido havas bonan varmoreziston kaj varmokonduktivecon, kio povas kompensi la malbonan varmoreziston de galiumnitridaj aparatoj, do la industrio uzas duon-izolitan silician karbidon kiel substraton, kaj gan-epitaksa tavolo estas kreskigita sur la silicia karbido-substrato por fabriki RF-aparatojn.
Se estas malobservo, kontaktu forigu
Afiŝtempo: 16-a de Julio, 2024
